0755-89361696
136-9222-2061

圓晶切割(劃片)的過程中最容易發生的問題:空切和碎屑
㈠ 空切
空切發生的原因:
◆ 粘著麵不清潔
※解決(jue) 方法:
一般使用者遇到空切的問題時,通常都隻考慮到粘力不足,不常考慮到圓晶片背麵與(yu) 基板貼合麵的狀態,清洗貼合麵有助於(yu) 增加膠帶的貼合麵,通常使用的清洗方法大致有兩(liang) 種:
① 超聲波清洗
② 電解清洗
◆ 膠帶與(yu) 被粘著麵粘力不足。
※分析:
通常粘力=(膠帶與(yu) 晶片的接觸麵積)×(膠帶對晶圓或基板背麵的粘度)
所以當晶片越小,或是膠帶粘度低時會(hui) 產(chan) 生空切的機會(hui) 就越多。
針對空切的解決(jue) 方法:
① 選用粘度較大而解卷力又不太高的膠帶。
② 增加膠帶與(yu) 晶片背麵的接觸麵積(貼合之後固化)。
為(wei) 了增加膠帶與(yu) 晶圓的接觸麵積,可分為(wei) 預固化(預熱)與(yu) 貼合之後烘烤兩(liang) 種:
預固化:在貼合之前利用晶圓夾具台加溫,達到膠帶貼合到晶圓時膠帶的膠層稍微軟化,達到較好的貼合效果。
貼合之後的烘烤:預固化的效果沒有達到的需要的粘力,所以用此方法,預防在劃片過程中發生空切現象。
晶圓由於(yu) 在背麵研磨後有TTV值的存在,並非百分之百的平麵,用烤箱烘烤使膠層軟化,以達到填充晶圓背麵的微小凹麵,使膠帶與(yu) 晶圓背麵的接觸麵增加,以達到增加粘力的效果。
當膠層溫度由由低到高時,膠層的粘度變小,但膠的流動性變大,使膠層比較容易滲入不平整的晶圓背麵,以增加接觸麵積,當晶圓要切割之前,膠層又回到原來的溫度,因為(wei) 膠對溫度的變化是一種不可逆的過程。
由於(yu) 並非長時間烘烤,粘度並不會(hui) 大幅改變,主要改變粘力的因素在於(yu) 膠帶與(yu) 晶圓的接觸麵積的增加。

用烘烤的方法增加粘力,基本上有一些限製,當膠帶貼合到矽晶圓的背麵後以60 ℃熱源烘烤三分鍾其膠帶與(yu) 晶圓的接觸麵積已經達到80%以上,此時若再繼續烘烤十分鍾最多增加10%,所以我們(men) 可以得出結論,雖然烤的越久,膠帶與(yu) 晶圓的接觸麵積增加越多所以越粘,但後麵的烘烤時間也會(hui) 越沒效率。
烘烤的目的就是要增加粘性,對解決(jue) 空切而言當然越粘越好,但對於(yu) 晶片粘合而言, 膠帶越粘,頂針的力量就越大,對晶圓背麵留下的傷(shang) 痕的機會(hui) 也越大,所以建議使用晶圓切割膠帶時,如果晶片的尺寸小於(yu) 2mm×2mm,或是有如上述頂針刮痕的問題,建議使用UV膜膠帶。
㈡ 碎屑
碎屑大約可分為(wei) :
(1)上麵碎屑(2)背麵碎屑(3)邊角碎屑(4)破裂碎屑
發生碎屑的原因大致可分為(wei) 三大因素:
▲刀具因素 ▲晶圓材料的因素 ▲膠帶因素
▲ 刀具因素
① 切割速度越快
② 刀具主軸轉速越快
③ 晶片越小
④ DI 水噴的越少
▲ 晶圓材料的因素
① 有鈍化的晶圓會(hui) 比鏡麵晶圓較容易發生碎屑;
② 較薄的晶圓較容易發生碎屑;
※這裏主要針對膠帶因素來講講:
▲ 膠帶因素
1、碎屑的位置:
一般碎屑發生時應該都會(hui) 在晶片的同一邊,對晶片而言,第4個(ge) 切割邊常是最容易發生碎屑的地方。
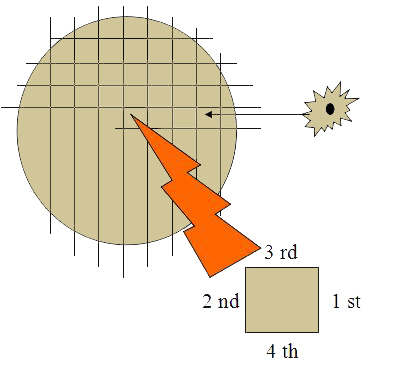
主要原因為(wei) :
(1)其切割地方的前方已經存在切割線。
(2) 對晶片而言,切割邊就是最後一個(ge) 支撐邊,如果沒有很優(you) 良的膠帶做為(wei) 切割平台, 晶圓很容易發生碎屑。
2、膠帶的製造誤差
製造誤差越小,膠帶的表麵越平整,碎屑的問題就越小。
解決(jue) 方法:如果使用一般的膠帶,那麽(me) 建議使用電子級的膠帶。
3、刀具切入膠帶的深度
基本上刀具穿晶圓後,切入膠帶的深度越大,越不容易碎屑,但是也不能切的太深。
※解決(jue) 方法:
⊙ 使用膠帶厚度較厚,同樣是PVC基材的膠帶。
⊙ 使用相同厚度的膠帶,但其基材必須為(wei) 不可擴展的膠帶。
⊙ 切割平台
圓晶切割(劃片)時會(hui) 碎屑的現象,除了以上原因外,最重要的原因在於(yu) 劃片過程中如何保持晶片不受移動是非常重要的,膠層太軟,容易使晶片在劃片過程中晃動而產(chan) 生碎屑。
因為(wei) 膠層緊貼著晶圓,在劃片過程中,膠層的作用就等於(yu) 的切割平台。所以提高膠層硬度,使切割平台夠硬,碎屑問題就會(hui) 改善。